作爲這一輪 AI 浪潮最大的「賣鏟人」,英偉達時至今日還在高歌猛進,近期剛公布的財報顯示,最新一季的公司營收已經增至去年同期的 3.6 倍。所以也難怪,英偉達的一舉一動都牽動大量的關注。
幾天前,國際投行摩根士丹利發布報告指出,基於最新 Blackwell 架構的英偉達 GB200 超級芯片(CPU+GPU)將採用玻璃基板而非常見的有機基板,這也讓「玻璃基板」「玻璃芯片」受到更加廣泛的關注。
但實際上不只是英偉達可能要用玻璃基板做芯片,包括英特爾、三星、蘋果等企業也都或明或暗地看好「玻璃芯片」的到來。
在 AI 需求持續高漲的趨勢下,英特爾去年就率先推出用於下一代先進封裝的玻璃基板,並表示將在未來幾年推出完整的解決方案,首批基於玻璃基板的芯片將面向數據中心、AI 高性能計算領域。
三星還要更激進,今年 5 月初就宣布預計在 2026 年面向高端 SiP(System-in-Package)量產玻璃基板。據報道,三星計劃在 9 月以前完成所有必要的設備採購與安裝,今年第四季度开始預商業生產线的運營。
那到底什么是玻璃基板?追趕 AI 浪潮的芯片巨頭爲什么都在盯着玻璃基板?基於玻璃基板的芯片——玻璃芯片又能給計算設備和普通用戶帶來什么價值?
玻璃芯片是什么?
算力,可以說是最近一年多 AI 浪潮中最經常被提及的一個詞。事實上,早在這一輪 AI 浪潮之前,更強的計算需求、更復雜的半導體電路都對大到芯片封裝工藝、小到基板材料提出了更高的要求。
了解芯片制造的讀者可能知道,切割下來的 die(裸芯片)在經過封裝之後才能稱之爲「芯片」,封裝既是爲了讓芯片能夠與外界進行電氣和信號的連接,也爲芯片提供了一個穩定的工作環境。
在這個過程中,通常使用有機材料作爲基板封裝芯片,而玻璃芯片的本質,就是將有機基板換成玻璃基板。不過相比之下,採用玻璃基板的芯片有更強的電氣性能、耐高溫能力以及更大的封裝尺寸。
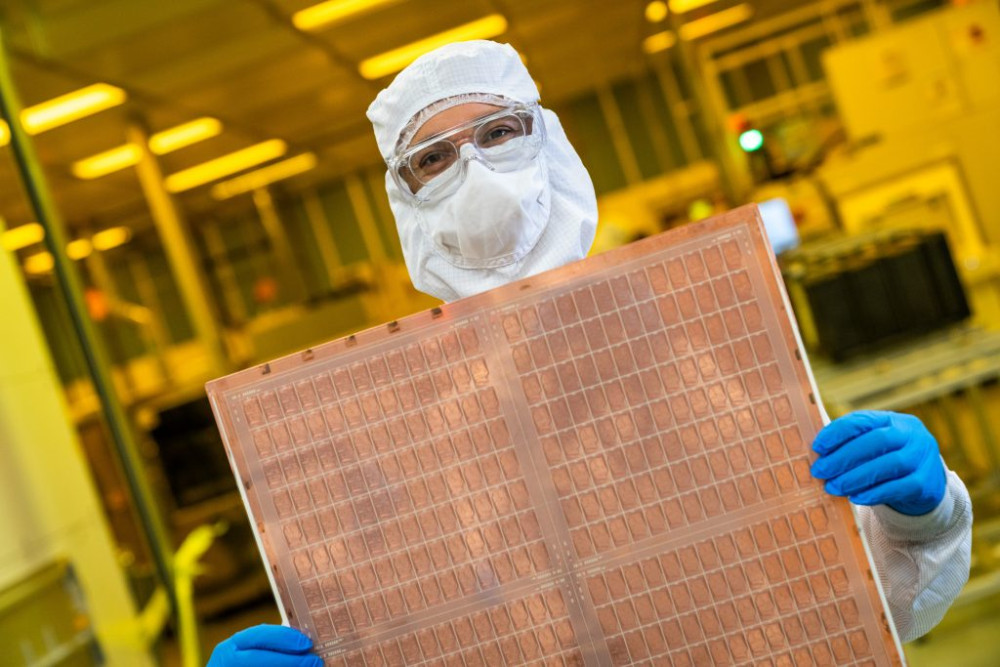
玻璃基板,圖/英特爾
更強的電氣性能,意味着玻璃基板可以允許更清晰的信號和電力傳輸,英特爾就指出玻璃基板能實現 448G 信號傳遞,做到更低的損耗。而低損耗,也意味着玻璃基板能夠幫助芯片變得更加省電。
此外,不同於有機塑料的粗糙表面,更平坦的玻璃基板也讓光刻和封裝變得更容易,同面積下的开孔數量更多。
同樣由於物理方面的特性,玻璃基板還有更強的熱穩定性和機械穩定性,在高性能計算芯片運行產生大量熱量的過程中,芯片會發生更少發生翹曲和形變。英特爾在引入 TGV 玻璃通孔技術後,將能通孔之間的間隔能夠小於 100 微米,直接能讓晶片之間的互連密度提升 10 倍。
不過以上這些可能還不是最重要的。相比有機基板,玻璃基板可以將芯片封裝尺寸做得更大,來塞下更多、更大的 die——也是更多的晶體管。按照英特爾的說法,他們能在玻璃基板上多放 50%的 die,大幅提升封裝密度。
所以無論從性能、功耗還是互連密度來看,玻璃基板,或者說玻璃芯片都是更好的選擇。從這個角度看,英偉達 GB200 如果真的採用玻璃基板,一點也不讓人驚訝。
算力之爭,战火蔓延
在摩爾定律不斷逼近物理極限的現在,單片 die 的性能實質已經很難提升,但與此同時,高計算性能的需求也變得越來越迫切。而 Chiplet(小芯片)技術,已經被普遍視爲未來提升芯片算力的主要手段之一。
今年 3 月,英偉達在 GTC 开發者大會上發布了新一代 Blackwell GPU 架構,以及基於此架構的 GB200 超級芯片。GB200 標志了英偉達正式邁向 Chiplet,每個 GB200 實際上包含了 2 個 B200 GPU 和 1 個 Grace CPU,其中每個 B200 GPU 都有 2080 億個晶體管。
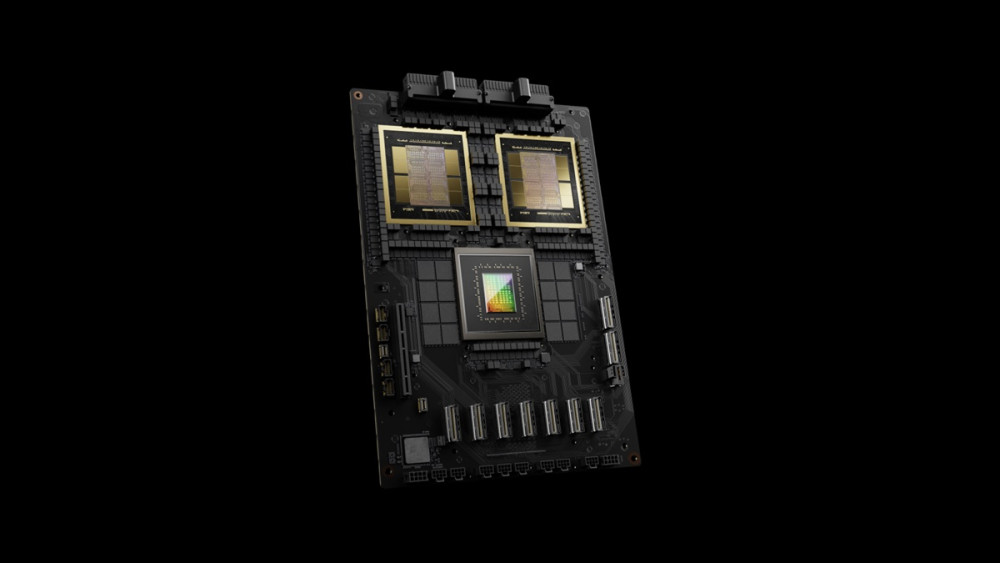
GB200,圖/英偉達
此外,相比上一代 H100 訓練一個 1.8 萬億參數模型需要 8000 個 Hopper GPU 和 15 兆瓦的電力,這一代的 B200,只需要 2000 個 Blackwell GPU 和 4 兆瓦的電力就能完成。
Chiplet 技術簡單來說,其實就是在單個封裝中集成多個 die 或小芯片,或者通俗理解爲將多個小芯片用「膠水」連起來,形成一個更強的芯片,比如英偉達的 GB200、蘋果的 M2 Ultra 等。
但 Chiplet 的趨勢,其實也對基板的信號傳輸速度、供電能力、設計和穩定性提出了新的要求。不過有機基板受限於物理特性,已經越來越不夠用,這也是玻璃基板越來越受到重視的核心之一。
另一方面,這也是先進封裝工藝領域的競爭使然。
當下,台積電 CoWoS 封裝工藝獨步天下,擁有較高的技術和專利壁壘。在市場層面,台積電也憑借 CoWoS 封裝工藝基本喫下了頭部芯片設計公司的大部分 AI 芯片訂單,從英偉達到 AMD,從谷歌到微軟。
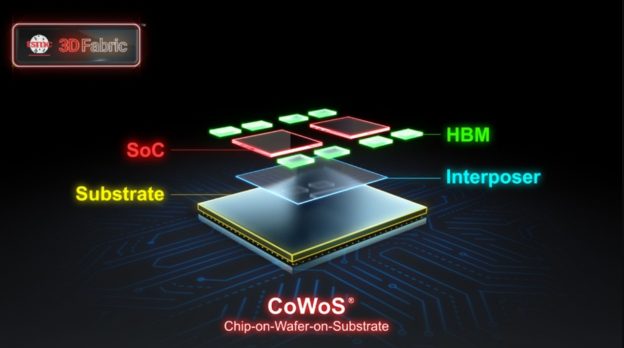
CoWoS,圖/台積電
作爲對手,英特爾和三星顯然不會甘愿。但除了在相似的技術路线上加緊追趕台積電的封裝工藝,英特爾和三星可能也明白很難在這條路上超越台積電。相比之下,玻璃基板或許會是一個在封裝工藝上超越台積電的真正機會。
所以也就不難理解,從去年开始英特爾和三星兩家晶圓代工廠紛紛加碼玻璃基板,加速玻璃芯片的量產計劃。甚至根據產業分析師的透露,台積電也有類似的技術布局。
玻璃芯片離我們,還有多遠?
雖然三星預計 2026 年就能面向高端 SiP 量產玻璃基板,但我們想真正用上玻璃芯片,可能還有很長的一段距離。
事實上,大部分這類近未來的技術都會遭遇大規模量產和成本的挑战,玻璃基板雖然在性能、能效等方面優於有機基板,但實際上也面臨同樣的問題。最直接的一個表現就是,不管是三星還是英特爾,都強調了玻璃芯片將率先面向數據中心的 HPC 需求。
但這還是在順利量產的情況下,實際玻璃基板還牽扯到上下遊的配套技術和生態,每一個流程的進展都可能影響另一個流程規劃。
另外值得注意的是,更早布局玻璃基板相關技術的英特爾遠沒有三星那么激進,只是表明將在 2030 年前推出。這當然不能說明三星就無法在 2026 年實現量產,但確實值得更謹慎地看待三星的計劃。
更何況,三星的半導體部門也沒少放過這種衛星。
來源:雷科技
原文標題 : 玻璃芯片要火,多虧了AI
標題:玻璃芯片要火,多虧了AI
地址:https://www.utechfun.com/post/377329.html
