

為了滿足資料中心不斷攀升的高速運算與傳輸需求,從傳統電訊號快速過渡到光訊號傳輸時代才是最根本的解決之道,能成就此一世紀偉業的矽光子(Silicon Photonics,SiPh)遂成為全球積體電路與半導體產業發展的下一步。展望未來,矽光子不但成為半導體代工王國台灣再創巔峰的新契機,也成為中國大陸半導體保衛戰的最後長城。本文將著墨在各種能克服光電整合、轉換與互連難題的先進封裝技術上,全面探討矽光子封測技術的關鍵作用與新趨勢走向。
今年 3 月 5 日在聖地牙哥舉辧的 OFC 光纖通訊博覽會暨研討會(Optical Fiber Communication Conference and Exposition)上有很多廠家有志一同地展示各種 800G 的通訊產品(包括交換器與光收發模組),會場上思科(Cisco)及 Arsta 等廠商展示了具備 800G 通訊埠的交換器產品,Ranovus 介紹了自家採用共同封裝光學(Co-Packaged Optics,CPO)技術的 800G 光引擎。
至於博通(Broadcom)繼去年在 OCP 2022 開放運算計畫全球峰會上宣布一項在某超大規模資料中心(Hyperscale Data Center)部署該公司 Tomahawk 4 25.6T CPO 系統之合作案後,今年更進一步在 OFC 大會上展示 Tomahawk 5 51.2T Bailly CPO 原型系統。該公司強調,光是一台 Tomahawk 5 CPO 交換器就能替代 48 台 Tomahawk 1 交換器(2014 年推出)。
▲ Tomahawk 5-based 51.2T Bailly CPO switch with eight 6.4Tb/s光學引擎。(Source:Broadcom)
這一切在在說明了,隨著全球進入到以超大規模發展趨勢為核心的次世代資料中心時代後,各種乙太網路埠傳輸速率達到 800Gb/s 以上,同時交換頻寬上看 51.2Tb/s 的網通方案開始大量現身並做好量產的準備。一般而言,傳統 100G、400G 交換器多半使用銅線傳輸,但隨著交換器進入 800G 時代後,舊有的銅線傳輸漸漸展現頻寬不足、信號衰減、高能耗與高成本的劣勢,反而會限制 800G 交換器的發展。
日月光集團研發中心副總洪志斌表示,從今年的 OFC 大會就可以看到矽光子與 CPO 將成為帶動超大規模資料中心效率大幅成長的主流元件與技術,並主導今後高速交換器及其他光通訊產品的發展。面對電訊號必須走向光訊號,才能有效地將驚人大量資料傳輸效率顯著提升的重大課題,矽光子無異扮演了關鍵的角色。
元件微縮、減量與能耗一次搞定,CPO 取代傳統可插拔光收發器成趨勢
隨著大數據分析、HPC 高效能運算、物聯網以及生成式 AI 熱潮等資料密集型應用的不斷擴展,資料中心的流量也隨之爆漲。為了緩解資料中心的壓力,甚至進一步帶動次世代超大規模資料中心的蛻變,結合各種先進封裝技術的矽光子解決方案應運而生。事實上,先進矽光子封裝技術與資料中心互為表裡,在前者解決後者流量問題的同時,後者也成為帶動前者發展的重要驅動力。
當前資料中心內部光通訊需要藉助光收發模組(Optical Transceiver)來做為光傳輸終端與光纖之間的連接介面,並進行發送端與接收端之間的光轉電或電轉光的轉換作業。原則上,資料中心內部網路裡的所有交換器、路由器及節點都需要安裝光收發模組。若以擁有幾十萬台的資料中心而言,所部署的光收發模組往往達到驚人的幾百萬組。
面對數量極其驚人的各種光學元件,不論安裝、汰換、管理、採購與支出都是十分繁雜且沈重的負擔。更重要的是,業界預計可插拔光學元件在支援 1.6Tb/s、3.2Tb/s 或更高傳輸速率時會面臨性能極限。對此,業界分別從元件減量、微縮,以及透過矽光子、CPO 及其他先進封裝等技術來改善成本、能耗、能效及管理等問題。
由於矽光子能藉由 CMOS 製程把無數光學元件整合為一,自然成為資料中心光學元件減量的利器。洪志斌表示,隨著矽光子技術的推出,資料中心的光學元件數量至少減少了 30% 左右,整體光連接傳輸效益大增。再者,日月光運用矽穿孔(Through-Silicon Via,TSV)3D 封裝技術,將電子積體電路(EIC)與光子積體電路(PIC)堆疊在一起,進而將光學元件的體積微縮了 100 倍。不僅如此,在 TSV 3D 封裝中,矽光子晶片扮演了中介層的角色,因此能發揮縮短走線和降低功耗的顯著效益。
▲ TSV矽穿孔橫切面。(Source:Cadence)
事實上,近年來資料中心因應上述問題的主流新興解決方案莫過於 CPO,並且被視為取代傳統可插拔光收發模組的最佳替代方案。所謂 CPO 是一種能將網路交換器 IC 和光模組共同裝配在同一插槽上,進而形成晶片和模組之共同封裝的熱門解決方案。
▲ 4x OSFP800光收發器 vs. Cisco 3.2T CPO模組。(Source:Cisco)
進一步而言,CPO 透過先進封裝以及光電協同優化,有效縮短交換器 ASIC 晶片與光學模組之間的距離達到只有幾公釐(mm)的程度,同時也縮短了 SerDes 串行器/解串器(Serializer-Deserializer)的距離,因此能大幅降低功耗,並提升互連頻寬密度與能量效益(每位元傳輸資料所消耗的能量)。CPO 商用化目標就是價格上能比當前主流 400G 可插拔收發模組更低,隨著矽光子技術的日新月異並支援更高程度的光電異質整合,這個目標很快就能實現(預計 2024 年可達到每 Gb 成本 0.6 美元)。
事實上,如今市面上早已推出 800G 的商用矽光子可插拔光收發模組,洪志斌表示,整個資料中心可以透過這樣的模組實現高頻寬、高效率且低能耗的光傳輸,換言之,矽光子技術在滿足資料中心高效處理各種密集型應用的同時,也能為資料中心減少非常可觀的用電量。
當前舉凡英特爾、博通(Broadcom)、Marvell、Ranovus、AMD、Nvidia、Cisco 及 IBM 等廠商莫不大力佈局 CPO 方案。早在 2021 年,台積電便針對資料中心推出 COUPE 矽光子晶片異構整合技術,該技術即為一種 CPO 技術。至於微軟與 Meta 也在 2022 年積極將 CPO 技術導入自家資料中心的基礎設施中。至於日月光也在 2022 年推出的 VIPack 先進封裝平台中支援 CPO 封裝技術。日月光旗下矽品不久前才成功成為博通矽光子高速網通晶片/模組供應鏈成員,並提供 CPO 服務。
▲ 2022年矽光子光收發模組供應鏈 Player。(Source:Yole Group)
15 年磨一劍的矽光子,竟將日月光 40 年所有先進封裝技術全用上
進入後摩爾定律時代,隨著製程微縮難度與成本的不斷攀升,人們開始尋求先進製程之外的解決方案,運用各種先進封裝技術的異質整合(Heterogenous Integration,HI)概念遂應運而生。異質整合最吸人的地方莫過於能運用先進封裝技術將各種個別設計與製造的異質元件(例如專用處理器、DRAM、快閃記憶體、SMD 表面黏著元件、MEMS 微機電系統元件、感測器等)整合成為具備更進階功能的系統級封裝(System-in-Package,SiP)模組。
同樣的,當前各種矽光子產品的製造流程也涉及了各種先進封裝技術的組合。換言之,業界會運用各種先進封裝技術,來將各種 EIC、PIC 及主被動元件異質整合至 SiP 模組中。由於矽光子相容 CMOS 製程,所以採用微電子產業的量產製程與最佳實踐會是最切合實際且符合經濟效益的做法。
對於明年就要滿 40 歲的日月光來說,40 年的日月光封測史著實就是整個半導體業從傳統封裝到先進封裝進化史的縮影。洪志斌表示,該公司從釘架型封裝(Leadframe)、BGA 球柵陣列封裝等傳統封裝開始,接著在透過打線封裝(Wirebond)打下提升元件頻寬的基礎後,又導入覆晶封裝(Flip chip)達成 10 倍等級頻寬的提升要求。面對 100 倍頻寬的挑戰,該公司開始採用晶圓級先進封裝(Wafer Level Package, WLP)技術來克服,亦即前文提到透過 TSV 矽穿孔與 CoW(Chip on Wafer)封裝技術將 EIC 與 PIC 堆疊在一起,以實現 3D 立體封裝。

▲ 各項矽光子先進封裝一覽表。
「日月光投入矽光子技術的研發已超過 15 年,但在這 15 年間竟然將日月光 40 年來所發展出來的封裝技術全都用上了,」洪志斌強調。為了協助客戶協同運用各種先進製程,打造超高密度與效能的 3D 異質架構與生態系,該公司特別推出 VIPack 先進封裝平台。
該平台包含六大核心封裝技術:基於高密度重佈線層(Redistribution Layer,RDL)的扇出型堆疊封裝(Fanout Package-on-Package,FOPoP),扇出型基板上晶片封裝(Fanout Chip-on-Substrate,FOCoS ),Fanout Chip-on-Substrate-Bridge(FOCoS-Bridge)和扇出型系統級封裝(Fanout System-in-Package,FOSiP),以及基於 TSV 的 2.5D/3D IC 和 CPO 封裝。
▲ 日月光推出包含6大核心封裝技術的 VIPack 先進封裝平台。(Source:日月光)
洪志斌指出,當前半導體先進封裝的一大亮點,莫過於漸露開展之勢的扇出型封裝,其一大特點就是可以疊加在覆晶封裝上。首先,FOCoS 是日月光首創的創新封裝解決方案,該方案分成晶片先上 (2016) 與晶片後上 (2022) 兩種製程,能解決傳統覆晶封裝只能將 SoC 組裝在基板上的侷限性,並實現多晶片及小晶片(Chiplet)的整合。更重要的是,該方案能透過不同製程扇出平台技術達成最佳電性、應用連接來優化多晶片的異質/同質整合,並透過封裝設計套件(PDK)大幅縮短設計流程與時間。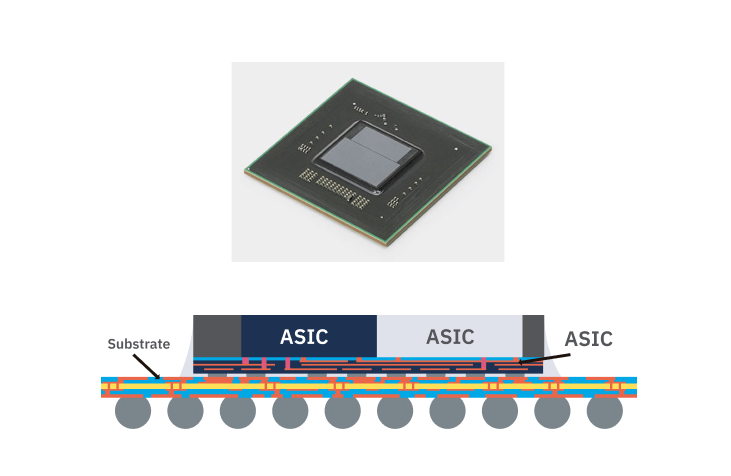
▲ 日月光FOCoS-CF晶片先上扇出型基板上晶片封裝。(Source:日月光)
其次 FOPoP 則是 VIPack 平台今年 3 月間新增的先進封裝技術,也成為該公司協助合作夥伴生態系開發 800G 矽光子可插拔光收發模組的最佳利器。該技術能將電氣路徑減少 3 倍,頻寬密度提升 8 倍,並讓矽光子引擎頻寬擴展到每單位 6.4Tbps,支援能在高溫下確保最小翹曲(Warpage)量的先進材料,提供次微米級精準度並有效改善光耦合效能。值得期的是,今後小尺寸矽光子引擎和 ASIC 專用晶片的整合封裝,也能在該技術的加持下變得更容易。
▲ 日月光 FOPoP 扇出型堆疊封裝。(Source:日月光)
矽光子既是產業發展一大技術槓桿,也是新興應用的新支點
就製程而言,2008 年矽光子漸露起飛之勢時,當時半導體製程開始進入 22 奈米,矽光子剛好可以填補中間節點 40 到 90 奈米的產能空缺,之後的矽光子大都採用同樣的製程。2018 年放棄 7 奈米開發計畫並開始將全付心力放在矽光子身上的晶圓代工大廠格羅方德(GlobalFoundries),其在 2021 年宣布全新鎖定資料中心高速光學內連市場而啟用的矽光子平台便採用 45 奈米製程,除此之外,該公司仍同時製造 90 奈米的矽光子產品。值得一提的是,早在 2017 年 3 月,矽光子晶片廠商 Luxtera(2018 年 12 月被 Cisco 收購)便宣布和台積電合作,共同開發使用台積電 7 奈米 CMOS 製程的矽光子技術平台。
洪志斌強調,隨著矽光子的蓬勃發展,它也促成了新一代供應鏈合作夥伴的串聯與整合,在矽光子生態供應鏈中,需要 IC 設計公司設計新一代矽光子積體電路、晶圓代工廠負責製造新一代 EIC 與 PIC 晶片,再由封測廠進行模組的封裝測試,最後再交由系統廠重新佈建新的系統。
這中間會有非常多元的驅動力,包括從晶片設計端、封裝測試端及系統整合端驅動而出關於設計製造規格、規範及想法的要求,抑或來自資料中心或伺服器等角度而主導的需求與價值。就以身處整個供應鏈中段的日月光而言,必須將上下遊合作夥伴各自不同的新需求、新技術與新方案串聯起來,才能一同打造出共贏共榮的矽光子價值鏈。
(首圖來源:shutterstock)

標題:矽光子引爆光傳輸!重新定義資料中心與現台灣產業價值鏈
地址:https://www.utechfun.com/post/222081.html
